一种去胶方法及去胶设备pdf
时间: 2024-11-22 01:55:43 | 作者: 江南全站官网登录手机版
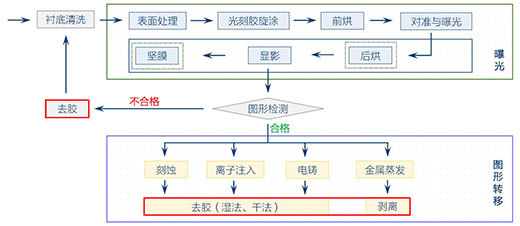
本发明的实施例提供了一种去胶方法及去胶设备,该去胶方法有:步骤一,在等离子产生室内中通入氧气;步骤二,向等离子产生室内通入第一气体;步骤三,将第一气体电离为第一等离子体;步骤四,将第一等离子体与载气装置通入的载气混合后通入去胶反应室;步骤五,在等离子产生室内通入氧气;步骤六,向等离子产生室内通入第二气体;步骤七,将第二气体电离为第二等离子体;步骤八,将第二等离子体与载气装置通入的载气混合后通入去胶反应室,其能够减轻等离子体对晶圆造成的损伤,提升产品良率。
(19)国家知识产权局 (12)发明专利申请 (10)申请公布号 CN 114850139 A (43)申请公布日 2022.08.05 (21)申请号 5.8 (22)申请日 2022.05.09 (71)申请人 无锡邑文电子科技有限公司 地址 214028 江苏省无锡市新吴区观山路1 号 (72)发明人 林政勋郭轲科 (74)专利代理机构 北京超凡宏宇专利代理事务 所(特殊普通合伙) 11463 专利代理师 刘桐亚 (51)Int.Cl. B08B 7/00 (2006.01) F25D 17/02 (2006.01) H01L 21/67 (2006.01) H01J 37/32 (2006.01) 权利要求书2页 说明书6页 附图3页 (54)发明名称 一种去胶方法及去胶设备 (57)摘要 本发明的实施例提供了一种去胶方法及去 胶设备,该去胶方法有:步骤一,在等离子产生 室内中通入氧气;步骤二,向等离子产生室内通 入第一气体;步骤三,将第一气体电离为第一等 离子体;步骤四,将第一等离子体与载气装置通 入的载气混合后通入去胶反应室;步骤五,在等 离子产生室内通入氧气;步骤六,向等离子产生 室内通入第二气体;步骤七,将第二气体电离为 第二等离子体;步骤八,将第二等离子体与载气 装置通入的载气混合后通入去胶反应室,其能够 减轻等离子体对晶圆造成的损伤,提升产品良 率。 A 9 3 1 0 5 8 4 1 1 N C CN 114850139 A 权利要求书 1/2页 1.一种去胶方法,应用于去胶设备,其特征是,所述去胶设备至少包括等离子产生 室、与所述等离子产生室下端连接的载气装置以及与所述载气装置下端连接的去胶反应 室,所述去胶方法有: 步骤一,在所述等离子产生室内中通入氧气使所述等离子产生室内的压力稳定在第一 压力值; 步骤二,向所述等离子产生室内通入用于对晶圆表明上进行预处理的第一气体; 步骤三,将所述第一气体电离为第一等离子体; 步骤四,将所述第一等离子体与所述载气装置通入的载气混合后通入去胶反应室,以 对所述去胶反应室中的晶圆进行活化反应; 步骤五,在所述等离子产生室内通入氧气使所述等离子产生室内的压力稳定在第二压 力值,所述第二压力值小于或等于第一压力值; 步骤六,向所述等离子产生室内通入用于对晶圆表明上进行去胶处理的第二气体; 步骤七,将所述第二气体电离为第二等离子体; 步骤八,将所述第二等离子体与载气装置通入的载气混合后通入去胶反应室,以对所 述去胶反应室中晶圆表面的光刻胶做处理。 2.依据权利要求1所述的去胶方法,其特征是,所述步骤三包括:通过向所述等离子 产生室施加第一射频功率将所述第一气体电离为第一等离子体; 所述步骤七包括:通过向所述等离子产生室施加第二射频功率将所述第二气体电离为 第二等离子体;其中,所述第一射频功率小于第二射频功率。 3.依据权利要求2所述的去胶方法,其特征是,所述第一射频功率为700W,所述第二 射频功率为900W。 4.依据权利要求1所述的去胶方法,其特征是,在所述步骤四中,所述载气的温度M 为:25℃≤M80℃,所述载气的流量为20sccm,通入时间为15秒; 在所述步骤八中,所述载气的温度M为:80℃≤M≤100℃,所述载气的流量为50sccm,通 入时间为60秒; 其中,所述载气为惰性气体,至少包括氩气。 5.依据权利要求1所述的去胶方法,其特征是,所述步骤一包括: 在所述等离子产生室内通入2000sccm的氧气,使所述等离子产生室内的压力在3秒内 达到第一压力值; 所述步骤五包括: 在所述等离子产生室内通入1000sccm的氧气,使所述等离子产生室内的压力在3秒内 达到第二压力值。 6.依据权利要求1所述的去胶方法,其特征是,所述步骤二包括: 向所述等离子产生室内通入用于对晶圆表明上进行预处理的流量为800sccm的H2+N2,其 中,H2:N2=10:100,所述等离子产生室内的压力设定为1.1T; 所述步骤六包括: 向所述等离子产生室内通入用于对晶圆表明上进行去胶处理的流量为200sccm的H2+N2, 其中,H2:N2=10:100,等离子产生室内的压力设定为1.1T。 7.根据权利要求1所述的去胶方法,其特征是,在所述步骤八之后,还包括: 2 2 CN 114850139 A 权利要求书 2/2页 步骤九、向等离子产生室内通入流量为2000sccm的氧气,以去除去胶反应室中的残留 气体。 8.依据权利要求7所述的去胶方法,其特征是,所述去胶方法还包括: 循环步骤二至步骤九,直至晶圆表面的光刻胶完全去除。 9.一种去胶设备,其特征是,所述去胶设备至少包括工控机和与工控机连接的PLC, 所述去胶设备还包括等离子产生室、与所述等离子产生室下端连接的载气装置以及与所述 载气装置下端连接的去胶反应室,所述工控机通过所述PLC控制所述去胶设备的等离子产 生室、载气装置、去胶反应室以执行权利要求1‑8任一项所述的去胶方法。 10.根据权利要求9所述的去胶设备,其特征是,所述去胶反应室内设置有冷却管路, 用以对晶圆进行冷却。 3 3 CN 114850139 A 说明书 1/6页 一种去胶方法及去胶设备 技术领域 [0001] 本发明涉及半导体技术领域,具体而言,涉及一种去胶方法及去胶设备。 背景技术 [0002] 等离子体划分成三类:高温等离子体(热核聚变等离子体),热等离子体(等离子体 弧、等离子体矩等);冷等离子体(低气压交直流、射频、微波等离子体以及高气压介质阻挡 放电、电晕放电、RF放电)。 [0003] 相比直流辉光放电,交流放电可以克服直流放电带来的等离子体的不均匀。而在 交流放电中又有低频和高频区分,低频交流等离子放电会因为的电极造成对等离子体 的污染,高频等离子体能改变处理的均匀性,并且无论有没有介质阻挡可以维持持续、均 匀、有效的放电。同时电子和离子在放电的半周期内到达不了电极,大幅度的降低了带电粒子的 损耗; [0004] 高频RF放电可以产生较均匀的等离子体,这主要是由于高频放电过程中,电子在 电场中往复运动,分子和电子发生碰撞,电子将能量传递给分子,使分子变为激发态,发生 电离形成等离子体。如果RF功率低就会导致等离子体还未到达晶圆表面就已经能量衰减 完,反应处理效果大幅度降低。而RF功率过高,虽能够保证等离子体充分电离,也就从另一方面代表着等 离子体密度大,在到达晶圆表面时因密度过大导致对晶圆造成过量的轰击,形成对晶圆损 伤严重,降低了后续晶圆的常规使用的寿命,造成产品良率低,附加值低。 发明内容 [0005] 本发明的目的包括,例如,提供了一种去胶方法,其能够减轻等离子体对晶圆造成 的损伤,提升产品良率。 [0006] 本发明的目的还包括,例如,提供了一种去胶设备,其能够减轻等离子体对晶圆造 成的损伤,提升产品良率。 [0007] 本发明的实施例能这样实现: [0008] 本发明的实施例提供了一种去胶方法,其包括:应用于去胶设备,所述去胶设备至 少包括等离子产生室、与所述等离子产生室下端连接的载气装置以及与所述载气装置下端 连接的去胶反应室,所述去胶方法有: [0009] 步骤一,在所述等离子产生室内中通入氧气使所述等离子产生室内的压力稳定在 第一压力值; [0010] 步骤二,向所述等离子产生室内通入用于对晶圆表明上进行预处理的第一气体; [0011] 步骤三,将所述第一气体电离为第一等离子体; [0012] 步骤四,将所述第一等离子体与所述载气装置通入的载气混合后通入去胶反应 室,以对所述去胶反应室中的晶圆进行活化反应; [0013] 步骤五,在所述等离子产生室内通入氧气使所述等离子产生室内的压力稳定在第 二压力值,所述第二压力值小于或等于第一压力值; 4 4 CN 114850139 A 说明书 2/6页 [0014] 步骤六,向所述等离子产生室内通入用于对晶圆表明上进行去胶处理的第二气体; [0015] 步骤七,将所述第二气体电离为第二等离子体; [0016] 步骤八,将所述第二等离子体与载气装置通入的载气混合后通入去胶反应室,以 对所述去胶反应室中晶圆表面的光刻胶做处理。 [0017] 可选的,所述步骤三包括:通过向所述等离子产生室施加第一射频功率将所述第 一气体电离为第一等离子体。 [0018] 所述步骤七包括:通过向所述等离子产生室施加第二射频功率将所述第二气体电 离为第二等离子体;其中,所述第一射频功率小于第二射频功率。 [0019] 可选的,所述第一射频功率为700W,所述第二射频功率为900W。 [0020] 可选的,在所述步骤四中,所述载气的温度M为:25℃≤M80℃,所述载气的流量为 20sccm,通入时间为15秒; [0021] 在所述步骤八中,所述载气的温度M为:80℃≤M≤100℃,所述载气的流量为 50sccm,通入时间为60秒; [0022] 其中,所述载气为惰性气体,至少包括氩气。 [0023] 可选的,所述步骤一包括: [0024] 在所述等离子产生室内通入2000sccm的氧气,使所述等离子产生室内的压力在3 秒内达到第一压力值; [0025] 所述步骤五包括: [0026] 在所述等离子产生室内通入1000sccm的氧气,使所述等离子产生室内的压力在3 秒内达到第二压力值。 [0027] 可选的,所述步骤二包括: [0028] 向所述等离子产生室内通入用于对晶圆表明上进行预处理的流量为800sccm的H2+ N2,其中,H2:N2=10:100,所述等离子产生室内的压力设定为1.1T; [0029] 所述步骤六包括: [0030] 向所述等离子产生室内通入用于对晶圆表明上进行去胶处理的流量为200sccm的 H2:N2,其中,H2:N2=10:100,等离子产生室内的压力设定为1.1T。 [0031] 可选的,在所述步骤八之后,还包括: [0032] 步骤九、向等离子产生室内通入流量为2000sccm的氧气,以去除去胶反应室中的 残留气体。 [0033] 可选的,所述去胶方法还包括: [0034] 循环步骤二至步骤九,直至晶圆表面的光刻胶完全去除。 [0035] 本发明的实施例提供了一种去胶设备,所述去胶设备至少包括工控机和与工控机 连接的PLC,所述去胶设备还包括等离子产生室、与所述等离子产生室下端连接的载气装置 以及与所述载气装置下端连接的去胶反应室,所述工控机通过所述PLC控制所述去胶设备 的等离子产生室、载气装置、去胶反应室以执行以上所述的去胶方法。 [0036] 可选的,所述去胶反应室内设置有冷却管路,用以对晶圆进行冷却。 [0037] 本发明实施例的去胶方法和去胶设备的有益效果包括,例如:通入氧气将等离子 产生室内的压力稳定在第一压力值后,向等离子产生室内通入第一气体并将第一气体电离 为第一等离子体,将第一等离子体与载气装置通入的载气混合后通入去胶反应室以去除去 5 5 CN 114850139 A 说明书 3/6页 胶反应室中晶圆表面的硬壳,对晶圆进行活化;随后再向等离子产生室内通入氧气使等离 子产生室内的压力稳定在第二压力值,再向等离子产生室内通入第二气体并将第二气体电 离为第二等离子体,将第二等离子体与载气装置通入的载气混合后通入去胶反应室,以对 晶圆表面的光刻胶做处理。在将第一等离子体和第二等离子体通入去胶反应室的过程 中,第一等离子体和第二等离子体均与载气混合后再通入去胶反应室,载气稀释了第一等 离子体和第二等离子体的密度,某些特定的程度上降低了等离子体在去胶过程中对晶圆的轰击, 减少了对晶圆的损伤。 附图说明 [0038] 为了更清楚地说明本发明实施例的技术方案,下面将对实施例中所需要用的附 图作简单地介绍,应当理解,以下附图仅示出了本发明的某些实施例,因此不应被看作是对 范围的限定,对于本领域普通技术人员来讲,在不付出创造性劳动的前提下,还能够准确的通过这 些附图获得其他相关的附图。 [0039] 图1为本申请实施例的去胶设备的结构示意图; [0040] 图2为本申请实施例的去胶方法中的步骤S100‑S900的流程图; [0041] 图3为本申请实施例的去胶方法中的子步骤S110的流程图; [0042] 图4为本申请实施例的去胶方法中的子步骤S210的流程图; [0043] 图5为本申请实施例的去胶方法中的子步骤S310的流程图; [0044] 图6为本申请实施例的去胶方法中的子步骤S510的流程图; [0045] 图7为本申请实施例的去胶方法中的子步骤S610的流程图; [0046] 图8为本申请实施例的去胶方法中的子步骤S710的流程图。 [0047] 图标:100‑去胶设备;200‑等离子产生室;210‑耦合线‑冷却管路。 具体实施方式 [0048] 为使本发明实施例的目的、技术方案和优点更加清楚,下面将结合本发明实施例 中的附图,对本发明实施例中的技术方案进行清楚、完整地描述,显然,所描述的实施例是 本发明一部分实施例,而不是全部的实施例。通常在此处附图中描述和示出的本发明实施 例的组件可以以各种不同的配置来布置和设计。 [0049] 因此,以下对在附图中提供的本发明的实施例的详细描述并非旨在限制要求保护 的本发明的范围,而是仅仅表示本发明的选定实施例。基于本发明中的实施例,本领域普通 技术人员在没有作出创造性劳动前提下所获得的所有其他实施例,都属于本发明保护的范 围。 [0050] 应注意到:相似的标号和字母在下面的附图中表示类似项,因此,一旦某一项在一 个附图中被定义,则在随后的附图中不需要对其进行进一步定义和解释。 [0051] 在本发明的描述中,需要说明的是,若出现术语“上”、“下”、“内”、“外”等指示的方 位或位置关系为基于附图所示的方位或位置关系,或者是该发明产品使用时惯常摆放的方 位或位置关系,仅是为便于描述本发明和简化描述,而不是指示或暗示所指的装置或元 件一定要有特定的方位、以特定的方位构造和操作,因此不能理解为对本发明的限制。 6 6 CN 114850139 A 说明书 4/6页 [0052] 此外,若出现术语“第一”、“第二”等仅用于区分描述,而不能理解为指示或暗示相 对重要性。 [0053] 需要说明的是,在不冲突的情况下,本发明的实施例中的特征可以相互结合。 [0054] 本申请的发明人发现,原有的去胶方法当中产生的等离子体密度较大,在到达晶 圆500表面时因密度过大导致对晶圆500造成过量的轰击,形成对晶圆500损伤严重,降低了 后续晶圆500的常规使用的寿命,造成产品良率低,附加值低;本申请实施例提供了一种去胶方法 及去胶设备100,用以解决上述技术问题。 [0055] 请参阅图1,本实施例提供的去胶设备100至少包括工控机、与工控机连接的PLC、 等离子产生室200、与等离子产生室200下端连接的载气装置400以及与载气装置400下端连 接的去胶反应室300。 [0056] 需要说明的是,等离子产生室200、载气装置400和去胶反应室300由上至下依次连 接,且等离子产生室200和去胶反应室300相连通;待去胶的晶圆500设置于去胶反应室300 内。等离子产生室200上绕设有耦合线,用于对气体进行电离以形成等离子体,PLC分 别与耦合线下端还设置有抽气管路,抽气管路连接气泵以将去胶反应室300内 的气体抽出,抽气管路上设置蝶阀,经过控制蝶阀的开口角度以控制等离子产生室200或去 胶反应室300的压力,蝶阀与PLC电连接。 [0058] 另外,反应腔内设置有冷却管路600,用以对晶圆500进行冷却。 [0059] 其中一种实施例中,冷却管路600设置于去胶反应室300内,冷却管路600内通有循 环的冷却水,用以持续对晶圆500进行冷却,以在等离子体持续对晶圆500进行冲击升温的 过程中,降低温升对晶圆500进行保护。 [0060] 可选的,冷却管路600内的冷却水的温度可设置为25‑40℃,本实施例选择25℃。 [0061] 请参阅图2,本实施例提供的去胶方法,应用于去胶设备100,该去胶方法有: [0062] 步骤S100、在等离子产生室200内中通入氧气使等离子产生室200内的压力稳定在 第一压力值。 [0063] 在等离子产生室200内中通入氧气,并使等离子产生室200内的压力稳定在第一压 力值,对等离子产生室200起到稳压的作用。 [0064] 其中,请结合图3,步骤S100包括: [0065] 子步骤S110、在等离子产生室200内通入2000sccm的氧气,使等离子产生室200内 的压力在3秒内达到第一压力值。 [0066] 可选的,第一压力值为2T。将通入氧气的气体体积流量限定在2000sccm,能够使得 氧气在3秒内充斥整个等离子产生室200,等离子产生室200内的压力快速达到第一压力值。 [0067] 步骤S200、向等离子产生室200内通入用于对晶圆500表明上进行预处理的第一气 体。 [0068] 需要说明的是,由于晶圆500的表面存在硬壳(碳氧氢化合物),故在对晶圆500进 行去胶前首先要去除晶圆500表面的硬壳。 [0069] 进一步的,请结合图4,步骤S200包括: [0070] 子步骤S210、向等离子产生室200内通入用于对晶圆500表明上进行预处理的流量为 800sccm的H2+N2,其中,H2:N2=10:100,等离子产生室200内的压力设定为1.1T。 7 7 CN 114850139 A 说明书 5/6页 [0071] 此步骤中,第一气体为800sccm的H2+N2,且H2:N2=10:100。 [0072] 步骤S300、将第一气体电离为第一等离子体。 [0073] 在将第一气体通入等离子产生室200内后,对耦合线通电以将第一气体电离 为第一等离子体。 [0074] 进一步的,请结合图5,步骤S300包括: [0075] 子步骤S310、通过向等离子产生室200施加第一射频功率将第一气体电离为第一 等离子体。 [0076] 可选的,第一射频功率为700W。通过耦合线W的 射频功率将第一气体电离为第一等离子体。 [0077] 步骤S400、将第一等离子体与载气装置400通入的载气混合后通入去胶反应室 300,以对去胶反应室300中的晶圆500进行活化反应。 [0078] 在此步骤中,载气的温度M为:25℃≤M80℃,例如,载气的温度设定为50℃,载气 的流量为20sccm,通入时间为15秒。 [0079] 将电离产生的第一等离子体与载气混合后通入去胶反应室300,该混合气体能够 去除晶圆500表面的硬壳,以对晶圆500进行活化。 [0080] 步骤S500、在等离子产生室200内通入氧气使等离子产生室200内的压力稳定在第 二压力值,其中,第二压力值小于或等于第一压力值。 [0081] 可选的,第二压力值为1.1T。对晶圆500进行活化后,再次向等离子产生室200内通 入氧气使等离子产生室200内的压力稳定在第二压力值。 [0082] 进一步的,请结合图6,步骤S500包括: [0083] 子步骤S510、在等离子产生室200内通入1000sccm的氧气,使等离子产生室200内 的压力在3秒内达到第二压力值。 [0084] 将通入氧气的气体体积流量限定在1000sccm,能够使得氧气在3秒内充斥整个等 离子产生室200,等离子产生室200内的压力快速达到第二压力值。 [0085] 步骤S600、向等离子产生室200内通入用于对晶圆500表明上进行去胶处理的第二气 体。 [0086] 需要说明的是,在去除晶圆500的表面的硬壳后,再通入第二气体以去除晶圆500 表面的光刻胶。 [0087] 进一步的,请结合图7,步骤S600包括: [0088] 子步骤S610、向等离子产生室200内通入用于对晶圆500表明上进行去胶处理的流量 为200sccm的H2:N2,其中,H2:N2=10:100,等离子产生室200内的压力设定为1.1T。 [0089] 此步骤中,第二气体为200sccm的H2+N2,且H2:N2=10:100。 [0090] 步骤S700、将第二气体电离为第二等离子体。 [0091] 在将第二气体通入等离子产生室200内后,对耦合线通电以将第二气体电离 为第二等离子体。 [0092] 进一步的,请结合图8,步骤S700包括: [0093] 子步骤S710、通过向等离子产生室200施加第二射频功率将第二气体电离为第二 等离子体;其中,第一射频功率小于第二射频功率。 [0094] 可选的,第二射频功率为900W。通过耦合线 A 说明书 6/6页 射频功率将第二气体电离为第二等离子体。 [0095] 步骤S800、将第二等离子体与载气装置400通入的载气混合后通入去胶反应室 300,以对去胶反应室300中晶圆500表面的光刻胶做处理。 [0096] 在此步骤中,载气的温度M为:80℃≤M≤100℃,载气的温度设定为100℃,载气的 流量为50sccm,通入时间为60秒。 [0097] 其中,载气为惰性气体,至少包括氩气。 [0098] 将电离产生的第二等离子体与载气混合后通入去胶反应室300,该混合气体能够 去除晶圆500表面的光刻胶,完成去胶。 [0099] 在步骤S800之后,上述去胶方法还包括: [0100] 步骤S900、向等离子产生室200内通入流量为2000sccm的氧气,以去除去胶反应室 300中的残留气体。 [0101] 此步骤中,压力设定为2T,通入氧气进行腔室吹送,以去除去胶反应室300中的残 留气体。 [0102] 另外,去胶方法还包括: [0103] 循环步骤S200至步骤S900,直至晶圆500表面的光刻胶完全去除。 [0104] 根据本实施例提供的一种去胶方法,该去胶方法的工作原理是:首先在3s内向等 离子产生室200内通入氧气,流量设定为2000sccm,压力设定为2T,用以稳定整个腔室的压 力;再通入流量共计800sccm的第一气体,压力设定1.1T,对第一气体电离形成第一等离子 体后通入流量为20sccm加热后的载气,以去除晶圆500表面的硬壳,以对晶圆500进行活化; 随后再次通入氧气将等离子产生室200内的压力稳定在1.1T,随后再持续通入流量共计 200sccm的第二气体,对第二气体电离形成第二等离子体后通入流量为20sccm加热后的载 气,第二等离子体进入去胶反应室300后对晶圆500表明上进行去胶处理;载气对第一等离子 体或第二等离子体进行稀释以减轻第一等离子体或第二等离子体对晶圆500表面的轰击, 减轻晶圆500损伤的程度;去胶完毕后,通入流量为2000sccm的氧气,压力设定为2T,对整个 腔室进行吹送,直至腔室内残留的光刻胶挥发性聚合物排出腔室外。上述步骤可以重复执 行,以达到完全去胶的目的,获得低损伤的晶圆500。 [0105] 综上所述,本发明实施例提供了一种去胶方法及去胶设备100,在生成等离子体的 过程中,通入一定量的惰性气体对等离子体进行稀释,从而使得进入到去胶反应室300内的 等离子体不易对晶圆500造成较大冲击,减轻了晶圆500的损伤。本实施例中,工控机通过 PLC能控制去胶设备的等离子产生室、载气装置、去胶反应室以执行以上实施例中的去胶 方法。工控机可以是工业控制计算机等计算设备,其可以存储用于执行本实施例去胶方法 的控制系统软件程序,通过该控制系统软件程序,工控机可以产生控制PLC控制指令,并由PLC控制去 胶设备以执行本实施例的去胶方法。 [0106] 以上所述,仅为本发明的具体实施方式,但本发明的保护范围并不局限于此,任何 熟悉本技术领域的技术人员在本发明揭露的技术范围内,可轻易想到的变化或替换,都应 涵盖在本发明的保护范围以内。因此,本发明的保护范围应以所述权利要求的保护范围为 准。 9 9 CN 114850139 A 说明书附图 1/3页 图1 10 10 CN 114850139 A 说明书附图 2/3页 图2 图3 11 11 CN 114850139 A 说明书附图 3/3页 图4 图5 图6 图7 图8 12 12
2、成为VIP后,下载本文档将扣除1次下载权益。下载后,不支持退款、换文档。如有疑问加。
3、成为VIP后,您将拥有八大权益,权益包括:VIP文档下载权益、阅读免打扰、文档格式转换、高级专利检索、专属身份标志、高级客服、多端互通、版权登记。
4、VIP文档为合作方或网友上传,每下载1次, 网站将按照每个用户上传文档的质量评分、类型等,对文档贡献者给予高额补贴、流量扶持。如果你也想贡献VIP文档。上传文档
广东省深圳市龙岗区德琳学校初中部2022-2023学年七年级上学期期中考试英语试题(原卷版+解析).docx
广东省珠海市第四中学、立才学校、梅华中学2022-2023学年七年级上学期期中质量检验测试英语试题(原卷版+解析).docx
教科版2024-2025学年六年级科学上册第一单元第4课时《生物细胞》同步练习(含答案).docx
牛津沪教版七年级英语上册单元速记•巧练 Unit 7【单元测试 · 提高卷】.docx
牛津沪教版七年级英语上册单元速记•巧练 Unit 5【单元测试 · 基础卷】.docx
广东省深圳市南山区太子湾学校2022-2023学年七年级上学期期中考试英语试题(原卷版+解析).docx
广东省深圳市南山第二外国语学校(集团)2022-2023学年七年级上学期期中考试英语试题(含听力)(原卷版+解析).docx
牛津沪教版七年级英语上册单元速记•巧练 2023-2024学年七年级上学期期末英语全线).docx
广东省阳江市江城区2022-2023学年七年级上学期期中考试英语试题(原卷版+解析).docx
广东省梅州市梅县区宪梓中学2022-2023学年七年级上学期期中英语试题(原卷版+解析).docx
数据分析与可视化 课件 电子 第5、6章 Matplotlib可视化分析、 可视化分析进阶.pptx
Python数据分析 课件 项目5 数据可视化库Matplotlib.ppt
原创力文档创建于2008年,本站为文档C2C交易模式,即用户上传的文档直接分享给其他用户(可下载、阅读),本站只是中间服务平台,本站所有文档下载所得的收益归上传人所有。原创力文档是网络服务平台方,若您的权利被侵害,请发链接和相关诉求至 电线) ,上传者
相关新闻
推荐产品